怎样提高高功率脉冲磁控溅射(HiPIMS)沉积速率?电源、磁场、工艺自身!
摘要:高功率脉冲光磁控溅射(HiPIMS)沉积速率低,一直受到行业诟病,甚至成为其大批量应用的瓶颈。但是近些年国内外的科学家还是下了很多功夫进行攻关。下面将予以典型论述和分析。
点睛:提高HiPIMS镀膜的膜层沉积速率的方法
1.磁控靶磁场改变,如降低磁场、非平衡磁场等
2.脉冲电源波形改变,如多脉冲波形、正负波形等
3.镀膜工艺改变,如低气压、窄脉宽等
问题背景:
高功率脉冲磁控溅射工作在放电曲线的辉弧转化区域,相对于传统磁控,其工作电压高,放电电流大。这带来几个问题,一方面同样功率下,二次电子发射系数高,同样的电流时Ar粒子的束流会变小,因为电流中包含很多二次电子(注:二次电子随电压增高而增高,但对溅射率本身没有贡献)。同时由于较高的靶电压,离子回吸效应也强,等等效应。综合起来平均功率相等的前提下,HiPIMS的沉积速率低于常规直流,严重的时候低到30%。这在工业生产中是难以想象的。
经过这些年的研究和相关的文献查询,提高HIPIMS工艺方法的沉积速率,需要从磁控靶阴极、外部磁场、与外部等离子体源复合、HiPIMS磁控电源自身以及溅射沉积工艺等几个方面想办法。
1)正负脉冲增强
在HiPIMS脉冲结束后,在工件上加一个正电压,可以提高靶电压和等离子体电位,有助于真空室内的等离子体飞向工件,增加沉积速率。有报道研究了双极HiPIMS,钛靶,20 μs的负脉冲和一个相对较长的正脉冲来加速大多数离子向工件移动。结果比常规HiPIMS具有更高的沉积速率。对于碳靶,双极HiPIMS有利于离子的产生和向工件传输,同时sp3分数增加。反向脉冲电压为200 V时,sp3占比可提高约50%。
图1:左:脉冲波形,右:反向时间增加,沉积速率增加,可达30%,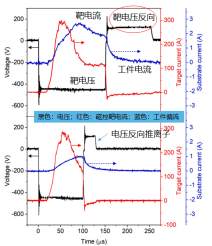
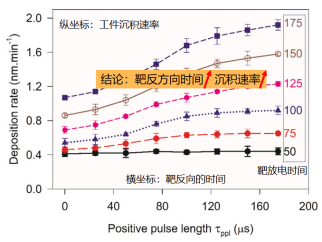
2)电源脉冲串
脉冲串可以优化沉积速率或离化率,在传统的单脉冲HiPIMS(也称为s-HiPIMS)或多脉冲波形(m-HiPIMS)中,需要考虑脉冲配置优化。对于这种情况(即s-HiPIMS),减少脉冲长度会增加沉积速率。较长的脉冲长度会增加回吸,产生较低的沉积速率。实际上短脉冲(3-10 μs)可以减少电弧。在后一种情况下,多脉冲配置可以观察到Ti沉积速率的增加。优化脉冲延迟时间可以使沉积速率提高50%。

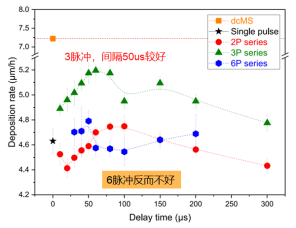
3)高低脉冲
利用阶梯脉冲的高功率脉冲磁控溅射(HiPIMS)技术,即放电由脉宽短、电压高的引燃脉冲和脉宽长、 电压低的工作脉冲2部分组成,有助于解决传统高功率脉冲磁控溅射沉积 速率低的问题。Cr靶测试,制备CrN薄膜。结果表明:随着引燃脉冲电压的施加,双脉冲高功率脉冲磁控溅射Cr靶放电瞬间建立,并获得较高的峰值电流,而传统HiPIMS模式的输出是渐渐爬升的三角波电流;与传统高功率脉冲磁控溅射相比,单位功率下双脉冲高功率脉冲磁控溅射具有更高的基体电流积分以及更多的Ar+ 和Cr0 数量;在实验条件下双脉冲高功率脉冲磁控溅射单位功率下CrN薄膜沉积速率为2.52 μm/(h ·kW),比传统高功率脉 冲磁控溅射提高近3倍。
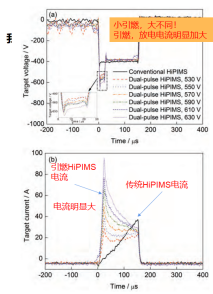
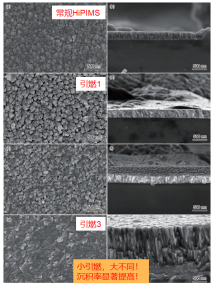
4)弱磁场增强
已经研究表明:降低磁场强度有助于HiPIMS沉积速率增加,甚至是标准磁铁组的几倍。有报道称具有多个约束区的对称圆形磁体组合提高了沉积速率。他们是这样解释的:创建一种磁场位型控制电子,通过双极性扩散和膨胀的等离子体导致离子沉积增加,从而在通往衬底的途中电离额外的中性离子,从而提高沉积速率。
图4:左:新磁场大大提高HiPIMS离化率, 右:新磁场离化率也高

总结:磁控溅射本源就是利用电磁场影响放电,而等离子体放电具有非线性,这就为电磁场增加沉积速率提供空间。无论单独磁场或电场或组合,都是在影响等离子体密度、离子/原子比、快电子数量、电子雪崩的快慢等等,进而影响了单位功率下的离化率和溅射率(沉积率)。
参考文献:R. Ganesan,SCT2023,Jake McLain, Vaccum2018,H. Larhlimi,SCT2023,吴厚朴,金属学报2019
 18922924269
18922924269
