HiPIMS:简单的方法就能调控磁控溅射中的金属/气体离子比?
1)磁控溅射:HiPIMS中简单的脉宽变化,就能调控膜层中的金属/气体离子比。
2)常规的磁控靶换成HiPIMS电源就可以达到上述效果。
高功率脉冲磁控溅射技术(HiPIMS)一直是磁控溅射领域的研究热点,自1999年HiPIMS被提出,其实也仅仅过去20几年,在工业领域还属于新生代,也一直在进行工业化推广。HiPIMS的技术优势也已经被普遍认可,相比传统DCMS,HiPIMS具有高等离子体密度、高金属离化率,这些优势在优化膜层质量都具有重要意义。
常规的DCMS主要是离化了气体粒子,通过施加偏压,使气体离子轰击膜层,我们希望获得高的离子轰击强度,但是高的气体离子轰击,气体粒子不是成膜粒子,很容易在对膜层轰击过程中,引入残余应力。而HiPIMS引入了更多的金属离子,从而在增加膜层低温生长期间膜层的致密性的同时,具有低的膜层应力。这里就出现了一个金属/气体离子比的概念,这个参数不像大多数等离子体状态那样容易监视,比如通常来说,高的功率、高的峰值靶电流密度,就会带来更高的等离子体密度、更高的金属离化率,那么我们在轰击基体的离子中,想获得高的金属/气离子比,怎么获得?
瑞典林雪平大学(也就是提出HiPIMS技术的大学)的G. Greczynski等人,在研究HiPIMS技术中就指出了,直接利用HiPIMS脉宽的调节,来很大范围内调控金属/气体离子比的方法。该研究以题为Control of the metal/gas ion ratio incident at the substrate plane during high-power impulse magnetron sputtering of transition metals in Ar 发表在《Thin Solid Films》杂志上。
G. Greczynski等人控制峰值靶功率一定,改变HiPIMS脉冲持续时间,分别研究了Ti、Zr、Hf靶在Ar气放电条件下,不同脉宽下到达基体的金属/气体离子通量。我们通过下图可以看到,Ti靶放电条件下,通过调节脉宽从30μs到120μs,Ti金属/Ar气体离子到达基体的通量比可以从约60调节到约为1。其实原因也很好理解,HiPIMS放电中,其靶电压和靶电流的波形耦合导致了在一个脉冲波形中,靶功率具有一个峰值,在靶功率峰值处,气体稀薄效应最强烈,可以理解为在这个峰值下,靶最热,使靶前的气体被排开,导致此时的气体粒子最少,从而使金属粒子有机可乘,此时金属/气体离子比最高。脉宽继续增加,靶功率峰值下降,气体粒子再次回归,金属/气体离子比下降。
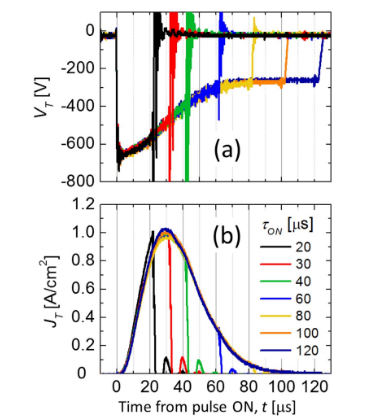
图1. (a)Ti靶电压和(b)Ti靶电流密度在不同HiPIMS脉冲持续时间(20-120μs)条件下的波形图。
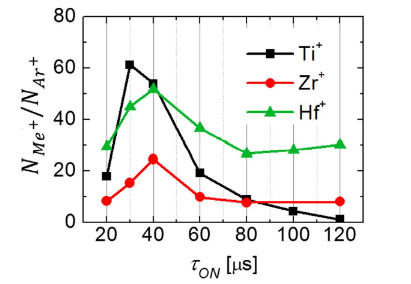
图2. Ti、Zr、Hf靶在Ar气放电条件下,不同脉宽下到达基体的金属/气体离子通量。
这种通过优化HiPIMS脉冲长度,直接调控金属/气体离子比,在工业应用中就很受用。对于常规的磁控靶换成HiPIMS电源就可以直接用于调控金属/气体离子比。文献中给出的气体离子是Ar+,对于其他气体(如:氮气、乙炔等)也适用。其实HiPIMS从实验室向工业推广的阻力,其实就是HiPMS技术的不稳定性和复杂性。如果能够探究清楚,这些参数对于等离子体状态的影响,从而进一步指导膜层优化,那对于我们产业界的技术迭代,具有重要的意义。
另一方面,我认为,HiPIMS相对于DCMS还有一个巨大优势,本身就在于其复杂性的提高,在于HiPIMS的放电模式是由脉冲波形组成的,而DCMS是一个稳定的直流。脉冲的存在直接在技术中多出了很多的参数窗口,脉宽、频率、占空比、电压峰值、电流峰值等等,参数窗口的增加,也进一步带来了技术的灵活可控性。
可以相信,随着镀膜工艺研究的深入和电源控制模式研发的进展,HiPIMS技术应用会越来越方便(甚至像直流磁控或中频磁控一样方便),也会得到越来越广泛的应用。
 18922924269
18922924269