HiPIMS长脉冲宽度调控——高导电铜膜&2.27μΩ·cm
点睛
长脉宽(≥200μs)使HiPIMS进入自溅射(SS)阶段,Cu⁺离子密度显著提升。铜膜电阻率从短脉宽的5.51μΩ·cm降至2.27μΩ·cm,接近块体铜1.67μΩ·cm;晶粒尺寸从21nm增至48nm,表面粗糙度降低,结合强度达10MPa。
引言
传统DCMS因功率密度低,溅射粒子电离率低、能量不足,导致铜膜导电性差、结合强度低。HiPIMS虽可实现高峰值功率,但脉冲宽度对放电模式是否进入自溅射SS阶段及膜层性能的影响尚不清晰。长脉冲能否使溅射进入SS阶段,从而提升离子通量并优化铜膜导电性?
解析:
哈尔滨工业大学(深圳)材料科学与工程学院的刘等采用HiPIMS技术,以“Influence of HiPIMS Pulse Widths on the Structure and Properties of Copper Films”为题发表在《Materials》上,其工艺参数如下:
1)基体:Si(100)晶圆、碳化硅陶瓷;2)预处理:酒精超声清洗;3)靶材:Cu靶,直径50.3mm;4)工作气体:Ar,流量100sccm,气压0.5Pa;5)电源参数:电压535V,脉宽30/50/100/200/300μs(对应频率1000/600/300/150/100Hz,保持占空比3%),平均功率180W;DCMS对比样:功率180W;6)基片:室温,沉积时间23-60min,膜厚约900nm。
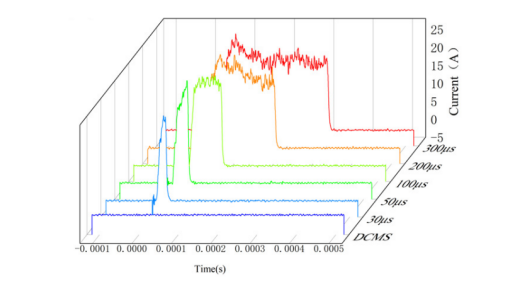
图1 DCMS与HiPIMS不同脉宽下的靶电流波形
图1a显示:DCMS电流约0.5A(直线)。HiPIMS中,脉宽30μs和50μs时电流呈尖峰状,放电仅依赖Ar⁺,未进入自溅射(SS)阶段。脉宽100μs时,电流升至一峰值后略有下降,但未完全进入平台期。脉宽≥200μs时,电流先升至一峰值,随后下降并进入平稳平台期——这是进入SS阶段的典型标志,此时溅射由Cu⁺自溅射主导,离子通量大幅提升。
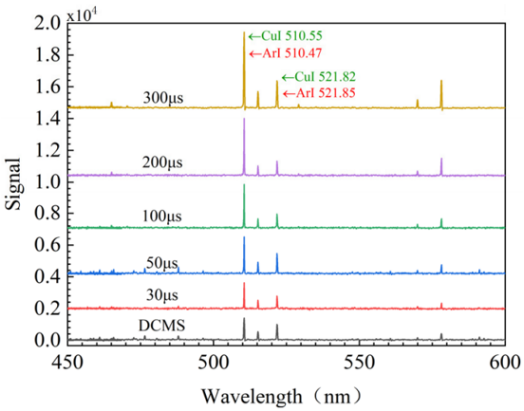
图2 DCMS与HiPIMS不同脉宽下的等离子体发射光谱
图2显示了HiPIMS的Cu⁺和Ar⁺信号显著高于DCMS。随着脉宽增加,Cu⁺和Ar⁺发射强度持续上升,尤其是脉宽≥200μs后Cu⁺增幅明显。Cu I 510.55nm相对强度(以300μs为基准)随脉宽增加而增加。这直接证明长脉宽进入SS阶段后,Cu⁺离子密度显著提高,为薄膜生长提供更多高能金属离子。

图3 DCMS与HiPIMS不同脉宽的Cu膜XRD及晶粒尺寸
图3a显示所有铜膜均为多晶,具有(111)择优取向。随脉宽增加,衍射峰强度增大,结晶度提高。图3c中晶粒尺寸:30μs时21nm,50μs时26nm,100μs时33nm,200μs时43nm,300μs时48nm。长脉宽下高离子通量提供充足能量促进晶粒生长。图3d显示残余拉应力:短脉宽时较高(>250MPa),脉宽≥100μs后降至150MPa以下,膜层更致密。
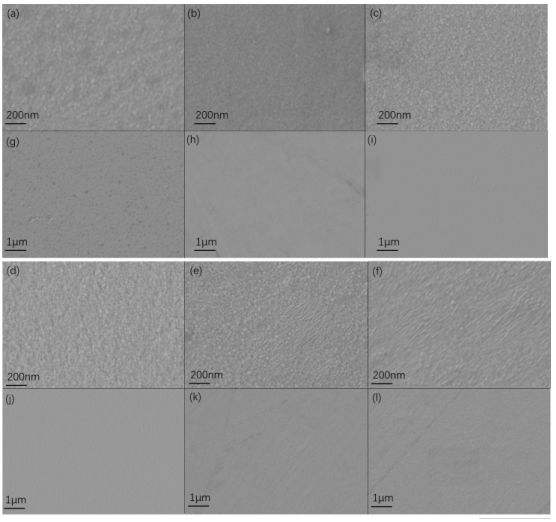
图4 DCMS与不同脉宽的HiPIMS的表面形貌:(a,g) DCMS;(b,h)30μs;(c,j)50μs;(d,f)100μs; (e,k)200μs;(f,i) 300μs
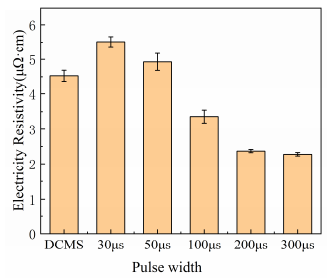
图5 DCMS与不同脉宽的HiPIMS的电阻率
由图4表面SEM观察到DCMS表面颗粒细小且凹凸不平;30-50μs脉宽时颗粒仍小;100μs时颗粒长大;200μs时颗粒开始合并呈长条状;300μs时合并加剧呈枝晶状。图5电阻率对比:DCMS为4.53μΩ·cm;30μs时5.51μΩ·cm;50μs时4.92μΩ·cm;100μs时3.36μΩ·cm;200μs时2.37μΩ·cm;300μs时2.27μΩ·cm。电阻率降低归因于晶粒增大减少晶界散射、表面形貌合并减少界面、致密度提高。
结论与延伸。;
1. HiPIMS铜膜导电性、结合强度和表面粗糙度均优于DCMS,归因于HiPIMS的高峰值功率和高电离率。
2. 脉宽≥200μs时放电进入自溅射(SS)阶段,Cu⁺离子密度大幅提升;短脉宽(≤50μs)仅依赖Ar⁺放电,离子通量低,膜层性能差。
3. 长脉宽优化性能:长脉宽300μs使晶粒尺寸增至48nm、电阻率降至2.27μΩ·cm,接近块体铜1.67μΩ·cm,表面形貌由颗粒状合并为枝晶状,减少界面散射。
论文DOI:10.3390/ma17102342

 18922924269
18922924269
