HiPIMS+DCMS联合沉积Ti-Cu涂层:真空退火调控Cu扩散与耐腐蚀性
点睛:
HiPIMS(Ti靶)提供高能Ti离子流,DCMS(Cu靶)提供高沉积速率Cu原子流,共溅射制备均匀Ti-Cu涂层。500℃真空退火使Ti沿晶界扩散至表面/界面、Cu富集于涂层中部,电阻率从173降至~100 μΩ·cm,Cu离子稳定释放0.8-1.0μM(30天)。
引言:
Ti-Cu涂层兼具钛的耐蚀生物相容性和铜的抗 菌导电性,但Ti和Cu的互扩散行为及退火对微观结构的影响尚不明确。HiPIMS可产生高密度Ti离子利于致密涂层,DCMS可快速溅射Cu提高沉积效率。两者联合能否制备出成分均匀、性能可调的Ti-Cu涂层?真空退火如何调控Cu扩散和腐蚀行为?
解析:
中国西南交通大学材料科学与工程学院的秦等人采用HiPIMS(Ti靶)+DCMS(Cu靶)共溅射制备了Ti-Cu涂层,并以“Ti–Cu Coatings Deposited by a Combination of HiPIMS and DC Magnetron Sputtering: The Role of Vacuum Annealing on Cu Diffusion, Microstructure, and Corrosion Resistance”为题发表在《Coatings》上,其工艺参数如下:
1)基体:单晶Si(100)晶圆、316L不锈钢;2)预处理:Ar离子溅射清洗基体:偏压-1500V,3Pa,15min;靶材预溅射10min去除氧化层;3)靶材:Ti靶和Cu靶,尺寸170mm×135mm×10mm;4)工作气体:Ar,压力0.6Pa;5)电源参数:Ti靶:电压-600V,频率100Hz,脉宽50μs;Cu靶:电流2A;6)基片偏压:-50V;7)沉积过程:基体以5rpm旋转,靶基距Ti靶140mm、Cu靶180mm,室温沉积10min,涂层厚度约250nm;8)退火工艺:真空(<1.0×10-3Pa),300℃、400℃、500℃各保温30min,随炉冷却。

图1 Ti-Cu涂层500℃退火后的断面TEM与元素分布
图1展示了500℃真空退火后涂层的微观结构和元素重分布。图1a低倍TEM显示涂层厚度约250nm,柱状结构明显。图1f的EDS线扫和图1g的元素面分布揭示了关键现象:Cu元素富集在涂层中部(绿色点密集),而Ti元素向涂层表面和Si界面扩散(红色点在顶部和底部富集)。这是由于Ti在Cu中的扩散系数大于Cu在Ti中的扩散系数,退火时Ti原子沿晶界等短程扩散路径迁移,将Cu“推”向中心。图1d的SAED花样标定为Ti3O、Cu2O和CuTi3相,图1b-c的HRTEM晶格条纹确认了氧化物纳米晶的存在,如d=0.247nm对应Ti3O。退火前Ti、Cu均匀分布;退火后Cu在涂层中部的原子浓度显著高于表面和界面。
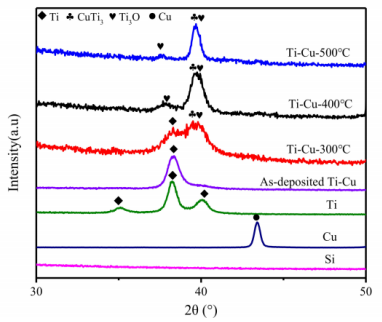
图2 Ti-Cu涂层退火前后的XRD图谱
沉积态未退火的Ti-Cu涂层仅显示Ti(002)的强峰,无Cu或Cu-Ti金属间化合物峰,表明Cu以非晶或极细晶形式存在。300℃退火后,出现Ti3O或CuTi3的宽化峰。400℃和500℃退火后,Ti3O或CuTi3的峰变得尖锐,半高宽从约0.5°降至0.3°,晶粒长大、结晶度提高。未检测到纯Cu或纯Ti的金属峰,表明退火过程中Ti和Cu主要转化为氧化物和金属间化合物。
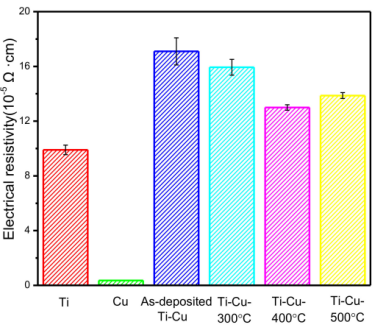
图3 Ti-Cu涂层退火前后的电阻率
纯Ti电阻率约99μΩ·cm,纯Cu约3.6μΩ·cm。沉积态Ti-Cu涂层电阻率高达173μΩ·cm,远高于纯金属。退火后电阻率显著下降:300℃退火后降至约140μΩ·cm,500℃退火后进一步降至约100μΩ·cm。由此证明了退火促使Ti向表面/界面扩散、Cu向中部富集,减少缺陷和固溶度,同时形成导电性较好的Ti3O和Cu2O,从而降低电阻率。
结论与延伸:
1. 采用HiPIMS(Ti靶)与DCMS(Cu靶)联合沉积,能充分发挥HiPIMS高离化率,高致密、高膜基结合力的特点和DCMS高沉积速率的优势,制备出成分均匀、厚度约250nm的Ti-Cu涂层。
2. 300-500℃真空退火使Ti沿晶界扩散至表面/界面、Cu富集于涂层中部,并形成Ti3O、Cu2O等氧化物,去除非平衡缺陷,使电阻率从173μΩ·cm降至约100μΩ·cm。
3. 在300℃退火条件下,Ti-Cu涂层耐腐蚀性佳,且所有退火涂层均能实现Cu离子稳定释放0.8-1.0μM(持续30天),为抗 菌导电涂层提供了简便有效的热处理调控路径。
论文DOI:10.3390/coatings10111064

 18922924269
18922924269
