HiPIMS金属填充工艺——纳米孔洞超填充&Cu vs Co
点睛:
采用HiPIMS技术结合偏压,Cu离子分数约50%,可实现纳米孔洞完美填充。DCMS因中性原子方向发散无法填充;Co虽放电功率更高,但离子到达基片分数仅34%,填充效果远逊于Cu。再溅射与再沉积是超填充的关键机理。
引言:
传统DCMS因溅射原子角度分布宽,无法均匀填充高深宽比纳米孔洞(易产生“夹断”)。HiPIMS可产生高离化率金属离子,通过电场引导离子垂直入射,能否实现无空洞填充?Cu和Co两种互连金属在HiPIMS中的填充行为有何差异?
解析:
瑞典乌普萨拉大学工程科学系的Jablonka Lukas等采用HiPIMS技术,以“High power impulse magnetron sputtering metal filling”为题发表在《Journal of Physics D: Applied Physics》上,其工艺参数如下:
1)基体:SiO2/Si;2)预处理:RCA清洗+HF刻蚀+热氧化;3)靶材:Cu或Co,直径50mm,厚3mm;4)工作气体:Ar,60sccm,Cu:0.5Pa,Co:1Pa;5)电源参数:脉宽50μs,频率Cu:100Hz,Co:60Hz,平均功率Cu:50W,Co:130W,峰值功率密度Cu:510W/cm²,Co:2200W/cm²;6)基片偏压:同步脉冲偏压,离子能量50-400eV;7)沉积过程:基片静止,靶基距8cm,沉积时间7-20min;8)对比工艺:DCMS(相同平均功率,无偏压)。

图1 Cu填充截面(倾斜20°)——(a)DCMS和(b-d)HiPIMS
图1a为DCMS沉积结果:顶部沉积厚,孔洞底部金属极少,出现典型的“夹断”现象。图1b-d为HiPIMS:50eV时,离子方向性改善,底部沉积增加;200eV时,顶部沉积速率降至DCMS的50%以下,底部填充更均匀;400eV时,顶部净沉积速率因再溅射趋近零,而底部仍稳定沉积,实现完美无空洞填充。Cu在200eV时自溅射产额已达1.0。
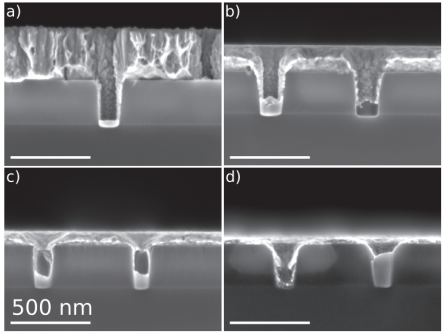
图2 Co填充截面(倾斜20°)(a)DCMS和HiPIMS(b-d)
Co的填充效果明显差于Cu。DCMS(图2a)几乎无底部沉积。HiPIMS中,即使离子能量提高到400eV(图2b-d),孔洞底部沉积仍很薄,且开口处出现明显的“悬垂”结构。尽管Co放电峰值功率密度(2200W/cm²)远高于Cu(510W/cm²),但填充性能反而不如Cu。这表明高功率并不直接等同于高离子通量到达基片。
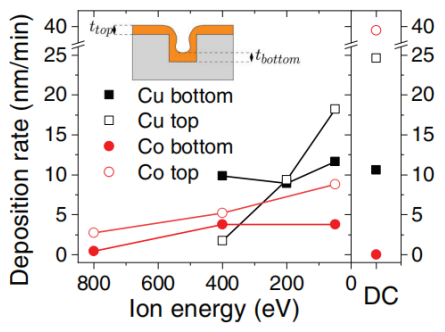
图3 顶部与底部沉积速率随离子能量的变化
DCMS时,Cu和Co的底部沉积速率均接近零。HiPIMS下,Cu在50eV时底部沉积速率Db已达1.5nm/min,随能量增加Db稳定在2nm/min,而顶部沉积速率Dt从7nm/min降至0.5nm/min。Co的Db大仅0.8nm/min。利用公式η = (1 - D/D₀)/Y估算离子金属分数:Cu为50%,Co仅为34%。尽管Co放电功率更高,但离子到达基片的分数更低,归因于Co靶所需强磁场导致离子回吸严重。
结论与延伸:
1. HiPIMS vs DCMS:DCMS因中性原子方向发散,无法填充纳米孔洞;HiPIMS通过高离化率金属离子结合偏压引导垂直入射,实现高深宽比结构的无空洞填充。
2. Cu vs Co:Co虽放电功率更高,但离子到达基片的分数更低,填充性能差;主要原因是Co靶所需强磁场导致离子回吸严重,优化磁控管磁场设计是提高离子通量的关键。
3. 填充机理:高能离子(>200eV)引发显著再溅射,优先去除孔口过量沉积,材料再沉积至孔底,形成自下而上的“超填充”效应;再沉积而非单纯方向性是实现完美填充的主因。
论文DOI:10.1088/1361-6463/ab28e2

 18922924269
18922924269
