HiPIMS靶材溅射速率
引言
HiPIMS由于高峰值电流及其高离化率,可以得到性能优异的致密膜层,伴随而来的HiPIMS溅射速率也会相对更低,本文将分析HiPIMS溅射速度低的原因及可能的改进方法。
点睛
1)HiPIMS溅射速率相对于DCMS溅射速率,离化率越高的靶材其溅射速率下降越快
2)HiPIMS溅射碳靶材,由于离化率低,溅射速率下降不大,而像Cu和Cr金属靶,HiPIMS下离化率越高,其自持溅射越高,溅射速率相对于越低。
内容
HIPIMS的溅射速率由溅射靶材,脉冲结构,反应溅射模式还有非反应溅射模式决定,在相同平均功率情况下HiPIMS溅射速率是DCMS溅射速率的15%-120%,如表1统计所示。从表1看,HiPIMS溅射速率相对DC溅射其速率普遍偏慢。
表1、不同材料溅射时HiPIMS与DCMS沉积速率比[1]

为理解HiPIMS溅射速率的减慢,需要关注溅射过程中两个阶段:A、等离子体和靶材的相互作用,即对靶材刻蚀速度影响,B、溅射离化物从靶材表面到基底表面的运输过程。等离子体与靶材相互作用:由于HiPIMS阴极的电压范围为400-2000V,而DCMS的电压300-400V,意味着相同功率的情况下,HPPMS的平均电流会更小,将导致溅射靶材的离子流将减少,因而带来靶材刻蚀速率下降。在离子运输阶段:HiPIMS获得的高离化率,将增加离化的金属离子重新朝向靶材运输而不是基底,即将有一部分离子在self-sputter,在等离子体区域自我放电状态。
为理解自持放电(self-sputter),测试不同靶材的在HiPIMS作用下的轰击靶材离子的成分,部分来自氩离子,部分来自靶材离子,如下表2所示。从中可以看到,以C靶材为例,在溅射中以Ar+为主,在离子流中不能存在C+主要是因为C的溅射产额太低,和C的离化势能比较高。同样低的溅射产额,导致低的溅射粒子流动,导致气体稀释现象降低。而Cr和Cu靶材由于溅射产额高及其离化率高,轰击靶材除Ar+之外,有接近一半的金属离子轰击。
由于不同材料的离化率不同,导致HiPIMS溅射中C的溅射速率不会偏离,而Cr和Cu则由于self-sputter自持溅射的存在导致HiPIMS溅射中低的溅射速率。
表2、500ev入射粒子下轰击靶面的氩离子与自溅射金属离子比例[2-3]
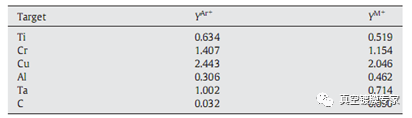
总结
1)HiPIMS溅射速率相对与DCMS溅射速率,离化率越高的靶材其溅射速率下降越快。
2)在长脉宽下,金属放电会进入自持放电模式可以增加离子种类和数量;像碳等高离化能材料,即使在长脉宽下也不能增加离化,溅射速率下降不明显。
 18922924269
18922924269
