HiPIMS放电制备纯金属薄膜的优势
HiPIMS放电使用的脉冲持续时间范围从几微秒到几百微秒,而脉冲重复频率范围从~10 Hz到~10 kHz。在这些条件下,HiPIMS放电的峰值电流密度可以达到A/m2量级,而DCMS只有A/cm2量级,但前者放电只占工作时间的~1%。因此,等离子体准时产生致密等离子体,不仅可以实现快速的靶溅射,还可以实现金属蒸气的高电离率。基于电探针诊断,HiPIMS中的电子能量分布函数是一个空间和时间相关的特征,在等离子体的开启和关闭时间中不断变化。等离子体密度在放电的强磁化区域内达到峰值,在这里发生电子约束,并且磁力线与靶表面平行。然后,等离子体向衬底膨胀,电子穿过磁阱扩散,填充电极间空间。在衬底位置的早期测量显示,电子密度峰值高达1011~1013 cm−3,这比在DCMS中观察到的要高几个数量级(见图1)。增加的电子密度(以及温度)意味着电离速率的提高,通过直接的电子冲击电离,极大地影响溅射金属原子的电离速率。因此通过HiPIMS技术可以制备高性能、特定结构的纯金属薄膜。
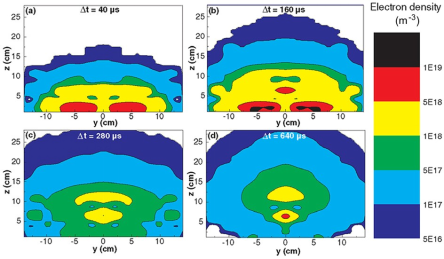
图1. Langmuir探针测量HiPIMS放电中不同延迟时间(△t = 40、160、280和640 μs)下电子密度的空间分布。压强是15pa,tON = 100 μs。使用直径150 mm的圆形钛靶(位于底部),Z表示到靶的距离
1. 利用HiPIMS技术调控Ti薄膜沉积过程的晶相
Ti在常温常压下呈现hcp相(α相),保持压力不变,在1163 K左右α相转变为致密的bcc相(β相),其相比于α相具有更强的延展性,力学性能与骨骼更匹配,因此被广泛用于生物医学植入体中。Ti的六方ω相则需要在高压条件下(2~7 GPa)形成。在大多数情况下,生长的Ti是α-相,但在HiPIMS条件下,Ti离子场的引入允许在低能量下形成fcc相 Ti,并诱导在非外延状态和高能量下形成ω相。其中离子密度和偏置电压对fcc相和ω相的形成起着至关重要的作用。此外Ti虽然被归类为低迁移率金属,但在HiPIMS沉积过程中,随着厚度的增加,应力发展经历了压缩-拉伸-压缩(CTC)三个阶段,生产不同厚度的钛膜,可以调整相组成。

图2.(a) DCMS体系,(b)无施加偏置的HiPIMS体系,(c)施加偏置为300 V的HiPIMS体系,(d)施加偏置为500 V的HiPIMS体系沉积Ti膜的XRD谱图,(e)退火前后Ti薄膜的XRD谱图,(f)不同偏压下α-相薄膜的织构系数。
2. HiPIMS控制生长金属薄膜的动力学效应
大功率脉冲磁控溅射(HiPIMS)及其变体调制脉冲功率磁控溅射(MPPMS)的出现,为控制溅射物质的通量提供了一个新的可能,即控制生长薄膜的动力学效应。为减少放电过程中电弧的产生,提出了一种新的MPPMS脉冲设计,即深振荡磁控溅射(DOMS)。通过直流磁控溅射(DCMS)放电的比较,发现DCMS沉积的Cr膜具有柱状形态,优先[110]取向,薄膜中仍然存在一些孔隙,力学性能始终低于块体材料。随着峰值功率的增加,DOMS工艺沉积的Cr膜沉积速率从DCMS沉积速率的60%下降到30%,薄膜具有[110]择优取向。随着峰值功率的的继续增加,薄膜形貌由柱状变为致密状,硬度提高至17 GPa,晶格参数增大,晶粒尺寸减小,薄膜的杨氏模量接近块体材料,无孔隙。

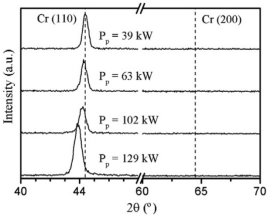
图3.迟发性脉冲的典型I-V波形和DOMS沉积的Cr膜的衍射图与靶峰值功率的函数关系
3. 利用HiPIMS技术外延生长择优取向金属薄膜
在等离子体沉积技术中,氩或氢辉光放电中的离子轰击通常用作步预处理工艺,为金属和半导体基板提供无污染物和天然氧化物的晶体表面。高电离金属通量被交替地用作预处理,使用HiPIMS和阴极电弧工艺,并结合施加在衬底上的高负直流偏置电压,能够产生具有明确化学性质的界面,从而提高了薄膜/衬底的附着力(与使用传统Ar辉光放电获得的结果相比),并促进后续沉积的薄膜局部外延生长。尽管使用上述概述的策略尚未实现整个薄膜的外延生长,但结果表明HiPIMS放电产生的离子轰击可以完全或部分去除存在于衬底表面的天然氧化物,并导致薄膜/衬底界面处的优先生长方向。基于HiPIMS的沉积工艺,通过衬底的直流偏置控制,在覆盖有天然氧化物的Si(001)取向晶片上可以生长厚达150 nm的外延Cu薄膜,而无需任何预处理工艺。当衬底的直流偏置电压为−130 V时,HiPIMS按照Cu(001) [100]//Si(001)[110]取向实现了Cu/Si的异质外延生长,而在相同的平均沉积条件下,使用传统的直流磁控溅射,沉积了具有[111]择优取向的多晶Cu薄膜。
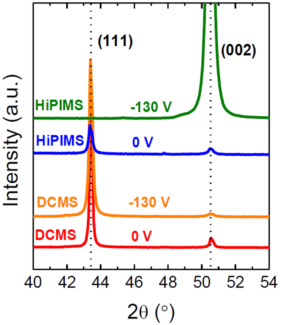

图4. 偏置电压对HiPIMS和DCMS制备的薄膜晶体结构的影响;−130 V偏压下Cu薄膜的{111}和{200}晶面族XRD极图
参考文献
[1] Cemin F, Lundin D, Furgeaud C, Michel A, Amiard G, Minea T, et al. Epitaxial growth of Cu(001) thin films onto Si(001) using a single-step HiPIMS process. Sci Rep. 2017;7:1655.
[2] Ferreira F, Serra R, Oliveira JC, Cavaleiro A. Effect of peak target power on the properties of Cr thin films sputtered by HiPIMS in deep oscillation magnetron sputtering (DOMS) mode. Surface and Coatings Technology. 2014;258:249-56.
[3] Dellasega D, Mirani F, Vavassori D, Conti C, Passoni M. Role of energetic ions in the growth of fcc and ω crystalline phases in Ti films deposited by HiPIMS. Applied Surface Science. 2021;556.
[4] Britun N, Minea T, Konstantinidis S, Snyders R. Plasma diagnostics for understanding the plasma–surface interaction in HiPIMS discharges: a review. Journal of Physics D: Applied Physics. 2014;47.
 18922924269
18922924269
