高功率脉冲磁控溅射技术(上)
高功率脉冲磁控溅射(HiPIMS),由Kouznetsov1等人于1999年提出,是在脉冲功率技术的基础上发展起来的一种极有前途的磁控溅射技术。为了将该技术与其他脉冲磁控溅射技术区分开来,一般定义为2:HiPIMS是峰值功率通常超过平均功率两个数量级的磁控溅射技术。在过去的20年里,人们对这项技术的兴趣日益增加。
HiPIMS的主要特点是结合了脉冲等离子体放电的标准磁控溅射,目的是通过大量的电离溅射材料,产生高度电离的等离子体3。溅射材料的高度电离沉积的膜层具有光滑致密的膜层特点4。而对反应沉积的化合物薄膜5,6,HiPIMS能够调控它们的相组成7、微观结构8以及机械9和光学性能5,7。相关研究已表明,它在提高薄膜附着力方面有着突出的表现10,能够在复杂形状的衬底上沉积均匀的薄膜11,12,并且具有较低的沉积温度13。因HiPIMS具有上述优势特点而极具工业开发的潜质。
一、HiPIMS产生高离化率等离子体的原因:
在磁控溅射等辉光放电过程中,往往难以实现大量电离溅射材料14-16。当沉积等离子体中离子组分比原子更多时,我们成为称为离子镀膜(IPVD)。目前有几种不同的IPVD技术,如蒸发后电离:放置在沉积室中的射频线圈产生离子,当施加负偏压时,可加速离子达到到基板表面17;另一种技术是阴极电弧蒸发,它利用局部极高电流放电可以产生高密集等离子体的特点,在特定的点周围产生高度电离等离子体18,19。
另一种实现IPVD的方法是使用HiPIMS。HiPIMS可以设置在一个传统的磁控溅射系统中,通过改变电源从而提供高功率脉冲的几千瓦每平方厘米的峰值功率,且可以避免磁控靶的损坏20,如图1所示。脉冲的长度通常保持在10~500μs21,22的范围,脉冲频率从几十赫兹到千赫兹17,23。在大多数HiPIMS过程中,脉冲期间施加的电压通常在500~1000 V左右,峰值电流密度(峰值放电电流/靶面积)最多达到每平方厘米几安培24。通过对磁控阴极使用非常高的瞬时功率密度,在HiPIMS脉冲期间,靶前方的载流子会大幅增加。在数字上,这意味着对于HiPIMS放电,靠近靶表面的电离区域的电子密度在1018~1019 m-3的数量级25,26。对于电子密度约为1019m-3的溅射金属原子,电离平均自由程约为1 cm,而对于电子密度为1017 m-3的直流磁控溅射(DCMS)放电,电离平均自由程约为50 cm27;因此,由于HiPIMS放电中的高电子密度,溅射材料的很大一部分因此被电离。
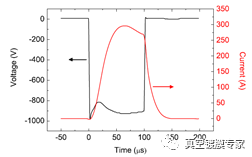
图1. 典型的大功率脉冲磁控溅射(HiPIMS)放电脉冲的电压和电流特性。此图是Cu在1.33Pa下放电,峰值电流密度达到约1.6 A cm-2.
 18922924269
18922924269



