双脉冲HiPIMS比传统HiPIMS沉积速率提高近3倍
-引言-
一种新型的高功率脉冲磁控溅射(HiPIMS)技术,即放电由脉宽短、电压高的引燃脉冲和脉宽长、电压低的工作脉冲2部分组成的双脉冲高功率脉冲磁控溅射技术,目的是解决传统高功率脉冲磁控溅射沉积速率低的问题。结果表明:双脉冲高功率脉冲磁控溅射单位功率下CrN薄膜沉积速率为2.52μm/(h·kW),比传统高功率脉冲磁控溅射提高近3倍。
-点睛-
利用高的引燃脉冲电压瞬间激发大电流,获得高的等离子体密度,在较低电压的工作脉冲下维持放电,减弱靶材对被离化粒子的回吸效应。在同样的输入功率下获得高的等离子体密度的同时,比传统HiPIMS技术具有更高的沉积速率。
-内容-
实验采用自行研制的多功能真空镀膜系统,该系统主要是由真空室、抽气系统(包括机械泵、分子泵)、供气系统、冷却系统以及控制系统等组成。实验选用纯度为99.99%的Cr靶,Cr靶的尺寸为400mm×100mm×13mm。双脉冲高功率脉冲电源系统引燃脉冲电压最高可达2000V,工作脉冲电压可达1000V,频率为100~1500Hz,占空比连续可调。双脉冲HiPIMS放电过程中,引燃脉冲电压分别为530、550、570、590、610和630 V,脉宽为20 μs,工作脉冲电压为 380 V,脉宽为 130 μs,频率500 Hz。传统 HiPIMS 放电过程中 ,脉冲电压为400 V,脉宽为150 μs,频率500 Hz。
图1双脉冲HiPIMS不同引燃脉冲电压及HiPIMS条件下CrN薄膜表面与截面形貌的SEM像
(a, b) 是传统HiPIMS;双脉冲HiPIMS (c, d)530 V, (e,f) 560 V, (g,h) 590 V, (i, j)620 V
从CrN薄膜的截面SEM像可以看出,传统HiP‐ IMS条件下薄膜厚度为0.321 μm,双脉冲HiPIMS条 件下,引燃脉冲电压从 530 V 到 620 V,薄膜厚度分 别为0.326、0.438、1.76以及1.38 μm。
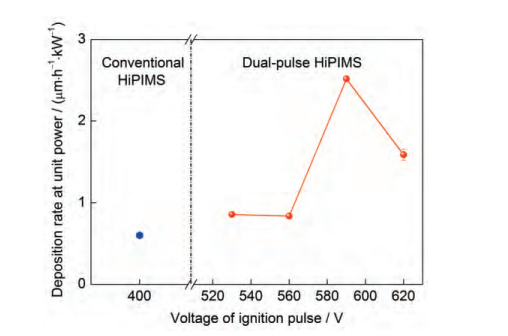 图2双脉冲 HiPIMS 引燃脉冲电压及 HiPIMS 条件对CrN薄膜单位功率沉积速率的影响
图2双脉冲 HiPIMS 引燃脉冲电压及 HiPIMS 条件对CrN薄膜单位功率沉积速率的影响
单位功率下,传统HiPIMS的沉积速率仅为0.60 μm/(h ·kW),而双脉冲HiPIMS的沉积速率均 高于传统HiPIMS,特别是在引燃脉冲电压为590 V 时,单位功率沉积速率达到2.52 μm/(h ·kW),比传统 HiPIMS 的沉积速率提高近 3 倍。
-结论-
(1)双脉冲HiPIMS使得同样电压下产生更高的放电电流。
(2)双脉冲HiPIMS在相同功率下产生更高等离子体密度。
(3)双脉冲HiPIMS比传统HiPIMS提高近3倍沉积速率,而且薄膜更加致密,晶粒更加细小。
(4)获得了一种高沉积速率的高功率脉冲磁控溅射技术,有望推动高离化磁控溅射技术的进步。
-参考文献-
[1]吴厚朴,田修波,张新宇等.双脉冲HiPIMS放电特性及CrN薄膜高速率沉积[J].金属学报,2019,55(03):299-307.
 18922924269
18922924269
