同步偏压配合HiPIMS能有什么神奇的化学反应呢?
引言:
HiPIMS技术广泛用于硬质涂层与金属薄膜沉积,在TiAlN、CrAlTiN等耐磨耐高温陶瓷涂层制备中表现成熟。该工艺通常需施加−100 V以上的基底偏压,以增强吸附原子迁移率并借助高能离子引发次注入效应,从而形成致密且力学性能的薄膜。然而,高偏压会同步加速工艺气体离子进入薄膜间隙位置,引入较高的压缩应力,成为该技术的主要局限。而同步偏压的出现,让我们看到了突破希望。
解析:
瑞士联邦表面科学与涂层技术实验室的Jyotish Patidar等人,采用反应性同步HiPIMS技术制备出高结晶质量、c轴择优取向的AlN(0002)织构薄膜。研究表明,相较于DCMS与常规HiPIMS,HiPIMS配合−30 V低同步偏压即可显著提升薄膜晶体结构与织构度,并通过金属离子同步策略有效抑制工艺气体夹杂与点缺陷形成。所得薄膜不仅具有优异的面外织构,晶粒还呈现均匀极化,展现出HiPIMS与同步偏压配合在沉积高性能功能薄膜方面的优势。该研究成果发表于《Surface & Coatings Technology》。
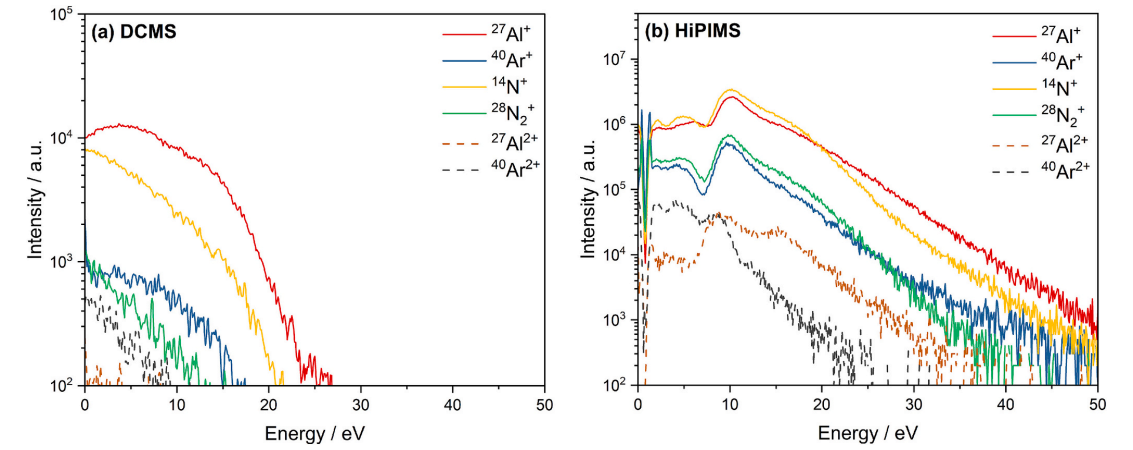
图1 (a)DCMS和(b)HiPIMS等离子体的离子能量分布图
图1对比了DCMS与HiPIMS等离子体中的入射离子能量分布。HiPIMS的离子计数率较DCMS高出两个数量级,其中铝离子动能中值由6.6 eV增至10.7 eV,氮离子亦呈相同趋势。HiPIMS放电中,Al+、N+和Ar+在不同能量区间呈现多峰分布,其主峰及高能尾部主要源于靶面氮化层在脉冲溅射中的离化产物。金属离子在HiPIMS总离子通量中的占比受脉冲参数、靶材状态与电流密度调控。该结果与Jouan等报道一致,HiPIMS独有的高能尾在Al+与N+中尤为显著,且因其整体电离率更高,基底接收的离子通量主要由这些高能离子主导。相对DCMS技术,HiPIMS的这种特性为同步偏压的配合调控有着天然的优势。

图2 基底脉冲与HiPIMS脉冲的同步
图2展示了铝靶上HiPIMS脉冲的离子电流-电压曲线,以及36Ar+和27Al+离子在质谱仪中被检测到的积分通量。显然,Ar+离子比Al+离子更早抵达基底。基于此,我们可以通过调整基底脉冲来优先加速金属离子向基底运动。需要特别说明的是,在富金属离子脉冲之间,基底偏压会主动调节至0V,从而降低原本显著的自偏压电位。此时入射的气体离子能量低于晶格位移阈值,因此薄膜结构主要受金属富集区域的离子辐照和动量转移影响。通过精准调控基底偏压脉冲,可选择性吸引金属离子进行高能轰击,从而在薄膜生长过程中有效避免气体离子掺入。
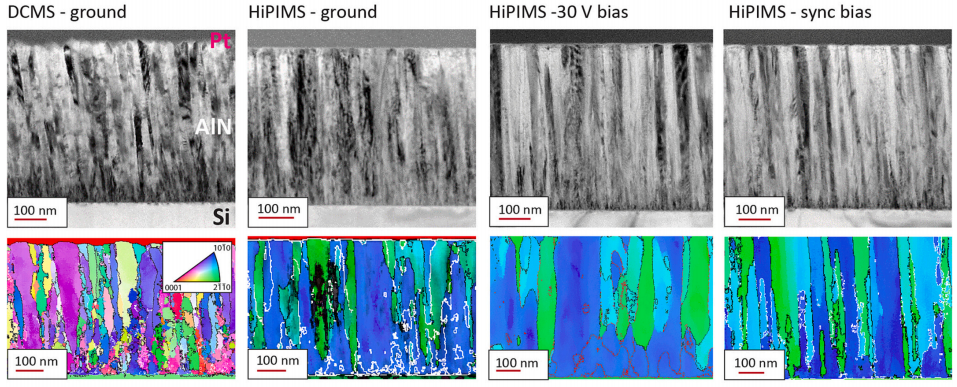
图3 四种代表性薄膜的明场与透射电镜成像
如图3所示,亮场TEM图像与通过SPED获得的相应取向图并列展示。所有AlN薄膜均呈现柱状结构。与DCMS薄膜相比,HiPIMS薄膜的晶粒尺寸和织构有所增加。晶粒尺寸的减小与DCMS过程中吸附原子迁移率降低的现象一致。HiPIMS薄膜,尤其是采用连续和脉冲偏压沉积的薄膜,显示出致密的柱状生长。当施加基底偏压时,晶粒尺寸进一步增大,晶粒延伸至薄膜全厚度。DCMS薄膜通常呈现随机取向的小晶粒,而同步偏压的HiPIMS薄膜则显示出高度取向的(0002)晶粒。这些结果表明采用HiPIMS与同步偏压配合在沉积高性能功能薄膜方面的有巨大优势。
延伸:
1)这项技术是“点杀”式能量注入,未来能否结合机器学习,实现离子轰击的全自动“自适应巡航”?
2)同步HiPIMS这把“手术刀”,能否用于雕刻其他对缺陷敏感的功能薄膜(如氧化物半导体、超导薄膜)?
 18922924269
18922924269
