直流偏压对HMDSO制备C:SiOX膜层性能的影响
HMDSO制备C:SiOX膜层具有优异的耐腐蚀性能,上篇讲到HMDSO/O2比例对膜层成分,耐腐蚀性能与硬度影响。在整个镀膜过程中,偏压也是影响HMDSO制备的C:SiOX膜层性能的因素之一。
A.J. Choudhury等人[1]使用RF-PACVD方式,使用HMDSO制备了C:SiOX膜层,并研究了偏压对膜层性能的影响。表1是各组实验参数,负偏压由40V至160V变化,离子能量也随之逐步增强;但是膜厚与沉积速率先增加后下降,在负偏压为100V时最高。

表1 各组实验参数
经过XPS分析,得到了每组膜层的SiO4,SiO3CH3,SiO2(CH3)2基团的比例。从图2中可以看出,随着负偏压由40V升至160V,膜层中无机硅(SiO4)含量先增加后减少,在100V时,含量最高;而有机硅(SiO3CH3,SiO2(CH3)2)含量却正好相反,先减小后增加,并且在100V时含量最低。

图2 不同偏压下无机硅与有机硅含量变化 (a)-40V, (b)-70V, (c)-100v, (d)-130V, (e)-160V
同时,研究人员也测试了各组样品的硬度以及划痕测试(如图3)。临界载荷,纳米硬度与水滴角都是随着负偏压的增加先增加后下降,在100V时达到极值。结合XPS结果分析,这些特性可能是因为在负偏压40V升至100V时,膜层中无机硅(SiO4)增加,Si-0-Si缺陷减少,导致膜层无机特性增加,硬度,临界载荷以及水滴角上升;在负偏压由100V升至160V时,离子能量逐渐增大,沉积时轰击基片能量也逐渐增大,溅射效应增加,导致膜层中i-0-Si缺陷增加,有机硅(SiO3CH3,SiO2(CH3)2)含量加大,相应的性能下降。
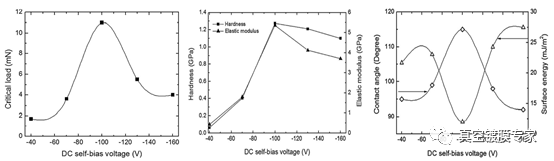
总结
使用RF-PACVD方式,以HMDSO制备了C:SiOX膜层时,膜层的纳米硬度,临界载荷以及水滴角等性能随着直流偏压的增加会先增加然后在减少,这是因为随着直流偏压增加,离子能量会增加,在某一临界能量前,对膜层有增益作用;超过该临界值,则会对原先膜层产生轰击,破坏原先膜层生涨结构,造成性能下降。
 18922924269
18922924269
